2023年5月18日
LSIコンタクトホールのTEMマッピング事例
LSIコンタクトホールの断面を観察を行い、同箇所においてTEM/EDSによる面分析(元素マップ)を行いました。
使用機器
分析透過電子顕微鏡(FE-TEM/EDS)
集束イオンビーム装置(FIB)
低エネルギーイオンミリング装置(Gentle Mill)
作業工程
FIB-マイクロプロービング法による試料作製 → 低エネルギーイオンミリング → STEM-EDS面分析
納期
担当職員にお問い合わせください。
測定例
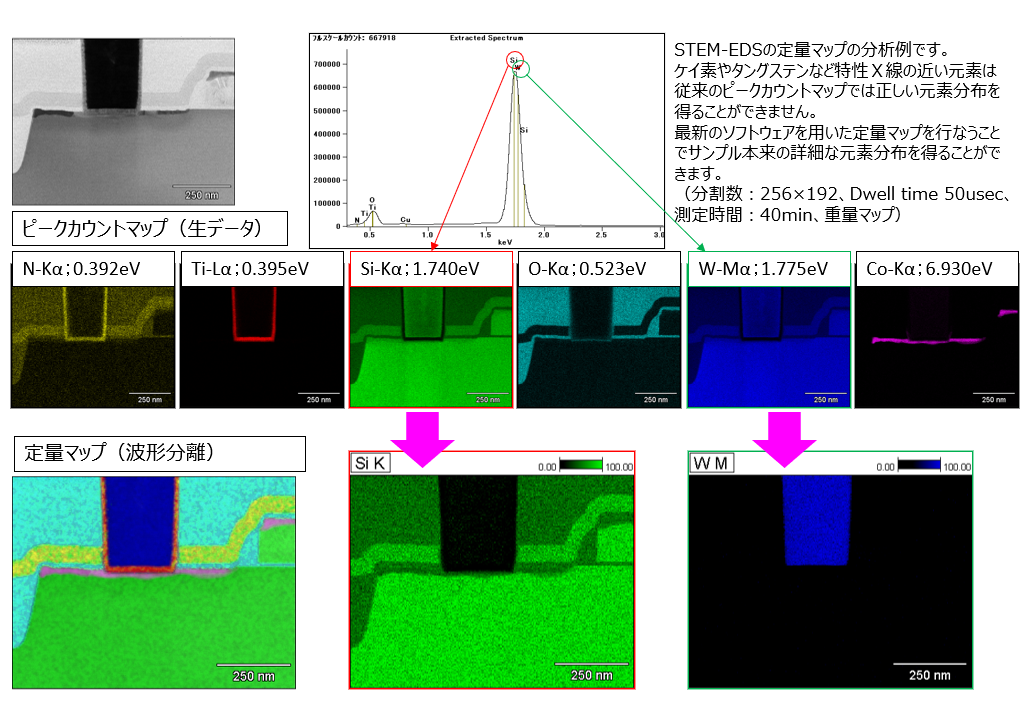
使用機器
料金
| NO. | 項目 | 単位 | 料金 |
|---|---|---|---|
| K120413-03 | 分析透過電子顕微鏡観察(FE-TEM/EDS)[EM002BF] 10万倍を超えて50万倍以下 |
倍率 10万倍を超えて50万倍以下 1視野につき |
25,850 |
| K120440-03 | TEM試料調製 FIB-マイクロプロービング法 低加速ガリウムイオン | 低加速ガリウムイオン仕上げ 1試料につき | 122,100 |
| K120437-03 | TEM試料調製 低エネルギーイオンミリング (ジェントルミル) | 1試料1条件につき | 14,850 |
| K120416-01 | 分析透過電子顕微鏡観察(FE-TEM/EDS)[EM002BF] 試料傾斜調整 |
試料傾斜調整 1条件ごとに | 13,420 |
| K120422-06 | 分析透過電子顕微鏡(FE-TEM/EDS)[EM002BF] 面分析 |
面分析 1視野5元素ごとに、または2時間につき |
109,230 |
ご利用方法
依頼試験(KISTEC事業名:試験計測)、委託受託(KISTEC事業名:技術開発受託)で利用できます。


![分析透過電子顕微鏡(FE-TEM/EDS)[EM002BF] 分析透過電子顕微鏡(FE-TEM/EDS)[EM002BF]](https://www.kistec.jp/connect/verbinden/wp-content/uploads/FE-TEM-EDS_EM002BF-1200x675-1.jpg)
![分析透過電子顕微鏡(FE-TEM/STEM/EDS)[Talos F200X] 分析透過電子顕微鏡(FE-TEM/STEM/EDS)[Talos F200X]](https://www.kistec.jp/connect/verbinden/wp-content/uploads/DSC03867-2-1.jpg)
![集束イオンビーム装置(マルチ解析用・FIB-SEM/EDS/EBSD)[Scios LoVacシステム] 集束イオンビーム装置(マルチ解析用・FIB-SEM/EDS/EBSD)[Scios LoVacシステム]1600x900](https://www.kistec.jp/connect/verbinden/wp-content/uploads/Scios_picture-1600x900-1.png)
![イオンミリング装置(低エネルギー型)[Gentle Mill IV5] イオンミリング装置(低エネルギー型)[Gentle Mill IV5]](https://www.kistec.jp/connect/verbinden/wp-content/uploads/f56326d57be04fd66a1a2acd83abca53.jpg)
